Cod QR

Despre noi
Produse
Contactaţi-ne


Fax
+86-579-87223657

E-mail

Abordare
Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
În semiconductori și afișajele de panou FPD, pregătirea peliculelor subțiri este un proces important. Există multe modalități de a pregăti pelicule subțiri (TF, Film subțire), următoarele două metode sunt comune:
● CVD (depunere de vapori chimici)
● PVD (depunere fizică în vapori)
Printre acestea, stratul tampon/stratul activ/stratul izolator sunt toate depuse în camera mașinii folosind PECVD.
● Folosiți gaze speciale: SIH4/NH3/N2O pentru depunerea filmelor SIN și SI/SiO2.
● Unele aparate CVD trebuie să utilizeze H2 pentru hidrogenare pentru a crește mobilitatea transportatorului.
● NF3 este un gaz de curățare. În comparație: F2 este foarte toxic, iar efectul de seră al SF6 este mai mare decât cel al NF3.
În procesul dispozitivului semiconductor, există mai multe tipuri de pelicule subțiri, pe lângă SiO2/Si/SiN obișnuit, există și W, Ti/TiN, HfO2, SiC etc.
Acesta este și motivul pentru care există multe tipuri de precursori pentru materiale avansate utilizate în industria semiconductorilor, pentru a face diverse tipuri de filme subțiri.
1.. Tipuri de BCV și unele gaze precursoare
2. Mecanismul de bază al CVD și al calității filmului
CVD este un concept foarte general și poate fi împărțit în mai multe tipuri. Cele obișnuite sunt:
● Pecvd: CVD îmbunătățită cu plasmă
● LPCVD: CVD de joasă presiune
● ALD: Depunerea stratului atomic
● MOCVD: CVD metalo-organic
În timpul procesului CVD, legăturile chimice ale precursorului trebuie să fie rupte înainte de reacțiile chimice.
Energia pentru ruperea legăturilor chimice provine din căldură, astfel încât temperatura camerei va fi relativ ridicată, ceea ce nu este prietenos cu unele procese, cum ar fi substratul de sticlă al panoului sau materialul PI al ecranului flexibil. Prin urmare, introducând altă energie (formarea Plasmei, etc.) pentru a reduce temperatura procesului pentru a satisface unele procese care necesită temperatură, bugetul termic va fi, de asemenea, redus.
Prin urmare, depunerea PECVD a A-Si: H/Sin/Poly-Si este utilizată pe scară largă în industria afișajului FPD. Precursori și filme CVD comune:
Silicon policristalin/Silicon cu un singur cristal SiO2 Sin/sion w/ti wsi2 hfo2/sic
Pașii mecanismului de bază al BCV:
1.. Precursorul reacției Gazul intră în cameră
2. Produse intermediare obținute prin reacția gazelor
3. Produșii intermediari ai gazului difuzează la suprafața substratului
4. Adsorbit pe suprafața substratului și difuzat
5. Reacția chimică are loc pe suprafața substratului, nuclearea/formarea insulei/formarea filmului
6. Produsele secundare sunt desorbite, pompate cu vid și evacuate după ce intră în scruber pentru tratament
După cum am menționat anterior, întregul proces include mai multe etape, cum ar fi difuzia/adsorbția/reacția. Rata generală de formare a filmului este afectată de mulți factori, cum ar fi temperatura/presiunea/tipul de gaz de reacție/tipul de substrat. Difuzia are un model de difuzie pentru predicție, adsorbția are o teorie de adsorbție, iar reacția chimică are o teorie a cineticii de reacție.
În întregul proces, cea mai lentă etapă determină întreaga viteză de reacție. Aceasta este foarte asemănătoare cu metoda căii critice a managementului de proiect. Cel mai lung flux de activitate determină cea mai scurtă durată a proiectului. Durata poate fi scurtată prin alocarea de resurse pentru a reduce timpul pe această cale. În mod similar, CVD poate găsi blocajul cheie care limitează rata de formare a filmului prin înțelegerea întregului proces și poate ajusta setările parametrilor pentru a obține rata ideală de formare a filmului.
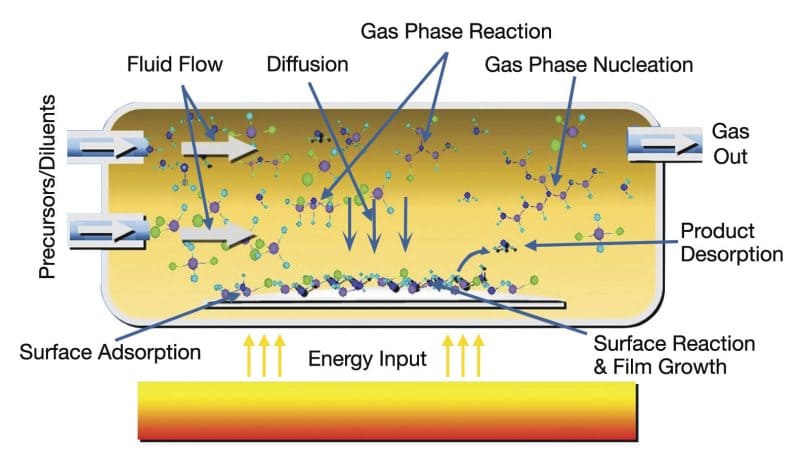
Unele filme sunt plate, altele sunt de umplere a găurilor, iar altele sunt de umplere a canelurilor, cu funcții foarte diferite. Mașinile comerciale CVD trebuie să îndeplinească cerințele de bază:
● Capacitate de procesare a mașinilor, rata de depunere
● Coerență
● Reacțiile în faza gazoasă nu pot produce particule. Este foarte important să nu produceți particule în faza gazoasă.
Unele alte cerințe de evaluare sunt următoarele:
● Acoperire bună a pasului
● Capacitatea de a umple lacunele de raport de aspect ridicat (conformitatea)
● O bună uniformitate a grosimii
● puritate și densitate ridicată
● Grad ridicat de perfecțiune structurală cu stres scăzut al filmului
● Proprietăți electrice bune
● aderență excelentă la materialul substratului



+86-579-87223657


Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Toate drepturile rezervate.
Links | Sitemap | RSS | XML | Politica de confidențialitate |
