Cod QR

Despre noi
Produse
Contactaţi-ne


Fax
+86-579-87223657

E-mail

Abordare
Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
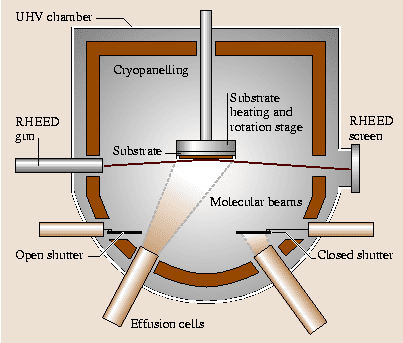
Un cuptor epitaxial este un dispozitiv utilizat pentru a produce materiale semiconductoare. Principiul său de lucru este de a depune materiale semiconductoare pe un substrat sub temperatură ridicată și presiune ridicată.
Creșterea epitaxială de siliciu este creșterea unui strat de cristal cu o bună integritate a structurii rețelei pe un substrat de siliciu monocristal cu o anumită orientare a cristalului și o rezistivitate de aceeași orientare a cristalului ca substratul și grosimi diferite.
● Creșterea epitaxială a stratului epitaxial de rezistență ridicat (scăzut) pe substratul de rezistență scăzut (ridicat)
● Creșterea epitaxială a stratului epitaxial de tip N (P) pe substratul de tip P (N)
● Combinată cu tehnologia de mască, creșterea epitaxială este realizată într -o zonă specificată
● Tipul și concentrația de dopaj pot fi schimbate, după cum este necesar, în timpul creșterii epitaxiale
● Creșterea compușilor eterogene, cu mai multe straturi, cu mai multe componente, cu componente variabile și straturi ultra-subțiri
● Realizați controlul grosimii la nivel atomic
● Creșteți materiale care nu pot fi trase în cristale unice
Componentele discrete semiconductoare și procesele de fabricare a circuitului integrate necesită tehnologie de creștere epitaxială. Deoarece semiconductorii conțin impurități de tip N și P, prin diferite tipuri de combinații, dispozitivele semiconductoare și circuitele integrate au diverse funcții, care pot fi realizate cu ușurință prin utilizarea tehnologiei de creștere epitaxială.
Metodele de creștere epitaxială a siliciului pot fi împărțite în epitaxie în fază de vapori, epitaxie în fază lichidă și epitaxie în fază solidă. În prezent, metoda de creștere a depunerii de vapori chimici este utilizată pe scară largă la nivel internațional pentru a îndeplini cerințele integrității cristalului, diversificarea structurii dispozitivului, dispozitiv simplu și controlabil, producție de loturi, asigurare de puritate și uniformitate.
Epitaxia în faza de vapori re-elaborează un singur strat de cristal pe o singură placă de siliciu de cristal, menținând moștenirea originală a zăbrelei. Temperatura de epitaxie în faza de vapori este mai mică, în principal pentru a asigura calitatea interfeței. Epitaxia în faza de vapori nu necesită dopaj. În ceea ce privește calitatea, epitaxia în faza de vapori este bună, dar lentă.
Echipamentul utilizat pentru epitaxia în faza de vapori chimici se numește de obicei reactor de creștere epitaxială. În general, este compus din patru părți: un sistem de control al fazelor de vapori, un sistem de control electronic, un corp de reactor și un sistem de evacuare.
Conform structurii camerei de reacție, există două tipuri de sisteme de creștere epitaxială de siliciu: orizontală și verticală. Tipul orizontal este rar utilizat, iar tipul vertical este împărțit în tipuri de placă plană și butoi. Într -un cuptor epitaxial vertical, baza se rotește continuu în timpul creșterii epitaxiale, astfel încât uniformitatea este bună, iar volumul de producție este mare.
Corpul reactorului este o bază de grafit de înaltă puritate, cu un tip de butoi de con, care a fost tratat special suspendat într-un clopot de cuarț de înaltă puritate. Napolii de siliciu sunt așezate pe bază și încălzite rapid și uniform folosind lămpi cu infraroșu. Axa centrală se poate roti pentru a forma o structură rezistentă la căldură rezistentă la căldură și rezistentă la căldură.
Principiul de lucru al echipamentului este următorul:
● Gazul de reacție intră în camera de reacție de la intrarea de gaz din partea de sus a borcanului de clopot, pulverizează din șase duze de cuarț dispuse într -un cerc, este blocat de defecțiunea de cuarț și se deplasează în jos între bază și borcanul de clopot, reacționează La temperatură ridicată și depozite și crește pe suprafața plafonului de siliciu, iar gazul de coadă de reacție este descărcat în partea de jos.
● Distribuția temperaturii 2061 Principiul încălzirii: o trecere înaltă și cu condiții ridicate trece prin bobina de inducție pentru a crea un câmp magnetic vortex. Baza este un conductor, care se află într -un câmp magnetic vortex, generând un curent indus, iar curentul încălzește baza.
Creșterea epitaxială în fază de vapori oferă un mediu de proces specific pentru a realiza creșterea unui strat subțire de cristale corespunzătoare fazei monocristaline pe un singur cristal, făcând pregătiri de bază pentru funcționalizarea scufundarii monocristalului. Ca proces special, structura cristalină a stratului subțire crescut este o continuare a substratului monocristal și menține o relație corespunzătoare cu orientarea cristalului a substratului.
În dezvoltarea științei și tehnologiei semiconductoarelor, epitaxia în fază de vapori a jucat un rol important. Această tehnologie a fost utilizată pe scară largă în producția industrială de dispozitive semiconductoare Si și circuite integrate.
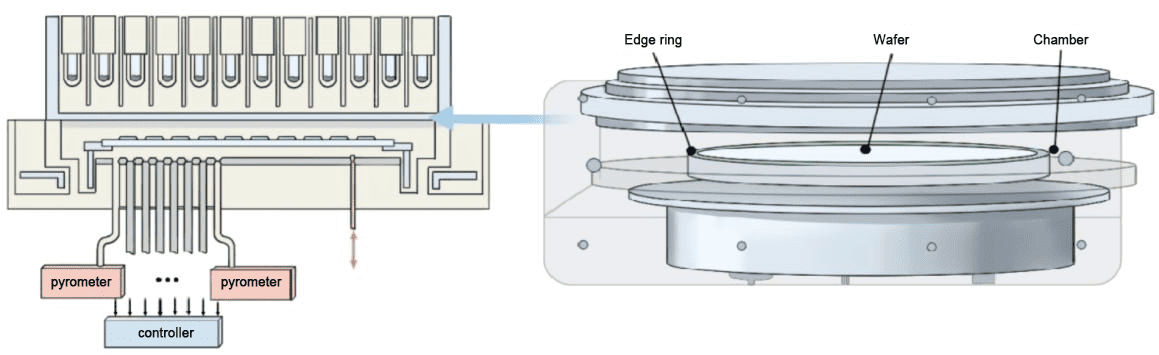
Metoda de creștere epitaxială în faza gazoasă
Gaze utilizate în echipamentele epitaxiale:
● Sursele de siliciu utilizate frecvent sunt SIH4, SIH2CL2, SIHCL3 și SICL4. Printre ele, SIH2CL2 este un gaz la temperatura camerei, ușor de utilizat și are o temperatură de reacție scăzută. Este o sursă de siliciu care s -a extins treptat în ultimii ani. SIH4 este, de asemenea, un gaz. Caracteristicile epitaxiei silane sunt temperatura de reacție scăzută, fără gaz coroziv și pot obține un strat epitaxial cu o distribuție abruptă a impurității.
● SiHCl3 și SiCl4 sunt lichide la temperatura camerei. Temperatura de creștere epitaxială este ridicată, dar rata de creștere este rapidă, ușor de purificat și sigur de utilizat, deci sunt surse de siliciu mai comune. SiCl4 a fost folosit mai ales în primele zile, iar utilizarea SiHCl3 și SiH2Cl2 a crescut treptat recent.
● Deoarece △ H a reacției de reducere a hidrogenului a surselor de siliciu, cum ar fi SICL4 și reacția de descompunere termică a SIH4 este pozitivă, adică creșterea temperaturii este condusă la depunerea siliciului, reactorul trebuie încălzit. Metodele de încălzire includ în principal încălzirea cu inducție de înaltă frecvență și încălzirea cu radiații cu infraroșu. De obicei, un piedestal format din grafit de înaltă puritate pentru plasarea substratului de siliciu este plasat într-o cameră de reacție din oțel sau oțel inoxidabil. Pentru a asigura calitatea stratului epitaxial de siliciu, suprafața piedestalului de grafit este acoperită cu SIC sau depusă cu peliculă de siliciu policristalin.
Producători înrudiți:
● Internațional: CVD Equipment Company din Statele Unite, GT Company din Statele Unite, Soitec Company din Franța, AS Company din Franța, Proto Flex Company din Statele Unite, Kurt J. Lesker Company din Statele Unite, Applied Materials Company din Statele Unite ale Americii.
● China: Al 48 -lea Institut of China Electronics Technology Group, Qingdao Sairuida, Hefei Kejing Materials Technology Co., Ltd.,Oferte Tehnologia Semicondutor Co., Ltd, Beijing Jinsheng Micronano, Jinan Liguan Electronic Technology Co., Ltd.
Aplicație principală:
Sistemul de epitaxie în fază lichidă este utilizat în principal pentru creșterea epitaxială în fază lichidă a filmelor epitaxiale în procesul de fabricație a dispozitivelor semiconductoare compuse și este un echipament de proces cheie în dezvoltarea și producția de dispozitive optoelectronice.
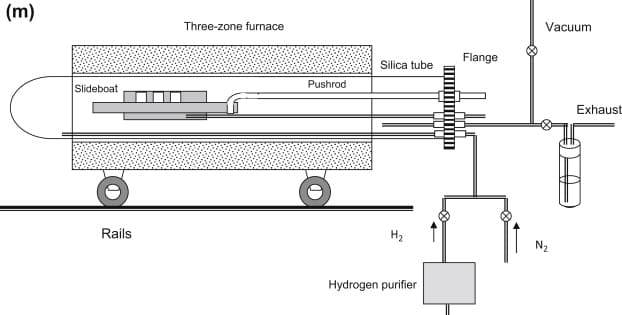
Caracteristici tehnice:
● Grad ridicat de automatizare. Cu excepția încărcării și descărcării, întregul proces este finalizat automat prin controlul computerului industrial.
● Operațiunile de proces pot fi completate de către manipulatori.
● Precizia de poziționare a mișcării manipulatorului este mai mică de 0,1 mm.
● Temperatura cuptorului este stabilă și repetabilă. Precizia zonei de temperatură constantă este mai bună decât ± 0,5 ℃. Rata de răcire poate fi ajustată în intervalul 0,1 ~ 6 ℃/min. Zona de temperatură constantă are o planeitate bună și o liniaritate bună a pantei în timpul procesului de răcire.
● Funcție de răcire perfectă.
● Funcție de protecție completă și fiabilă.
● Fiabilitatea ridicată a echipamentelor și o bună repetabilitate a procesului.
Vetek Semiconductor este un producător și furnizor profesionist de echipamente epitaxiale în China. Principalele noastre produse epitaxiale includSusceptor de butoi acoperit cu CVD, Susceptor de butoi acoperit cu sic, Susceptor de butoi de grafit acoperit SIC pentru EPI, CVD SiC Coating Wafer Epi Susceptor, Receptor rotativ din grafitetc. Vetek Semiconductor s -a angajat de mult timp să ofere soluții avansate de tehnologie și produse pentru procesarea epitaxială semiconductor și acceptă servicii de produse personalizate. Așteptăm sincer să devenim partenerul dvs. pe termen lung în China.
Dacă aveți întrebări sau aveți nevoie de detalii suplimentare, nu ezitați să luați legătura cu noi.
Mob/WhatsApp: +86-180 6922 0752
E-mail: anny@veteksemi.com



+86-579-87223657


Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Toate drepturile rezervate.
Links | Sitemap | RSS | XML | Politica de confidențialitate |
