Cod QR

Despre noi
Produse
Contactaţi-ne


Fax
+86-579-87223657

E-mail

Abordare
Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
Substraturile din carbură de siliciu au multe defecte și nu pot fi procesate direct. O peliculă subțire de un singur cristal trebuie să fie cultivată pe ele printr -un proces epitaxial pentru a face napolitane pentru cip. Acest film subțire este stratul epitaxial. Aproape toate dispozitivele din carbură de siliciu sunt realizate pe materiale epitaxiale. Materialele epitaxiale omogene de carbură de siliciu de înaltă calitate stau la dezvoltarea dispozitivelor de carbură de siliciu. Performanța materialelor epitaxiale determină în mod direct realizarea performanței dispozitivelor din carbură de siliciu.
Dispozitivele de carbură de siliciu cu curent ridicat și cu rentabilitate ridicată au prezentat cerințe mai stricte asupra morfologiei de suprafață, densității defectelor, dopajului și uniformității grosimii materialelor epitaxiale. Densitate de dimensiuni mari, cu defecte reduse și uniformitate ridicatăEpitaxie din carbură de siliciua devenit cheia dezvoltării industriei carburilor de siliciu.
Pregătirea de înaltă calitateEpitaxie din carbură de siliciuNecesită procese și echipamente avansate. Cea mai utilizată pe scară largă metodă de creștere epitaxială a carburii de siliciu este depunerea de vapori chimici (CVD), care are avantajele controlului precis al grosimii filmului epitaxial și a concentrației de dopaj, mai puține defecte, rata de creștere moderată și controlul automat al procesului. Este o tehnologie fiabilă care a fost comercializată cu succes.
Epitaxia CVD din carbură de siliciu folosește, în general, echipamente de BCV de perete cald sau perete cald, ceea ce asigură continuarea stratului epitaxial 4H Crystal SIC în condiții de temperatură de creștere mai mare (1500-1700 ℃). După ani de dezvoltare, CVD -ul peretelui cald sau al peretelui cald poate fi împărțit în reactoare de structură orizontală orizontală și reactoare de structură verticală verticală în funcție de relația dintre direcția debitului de gaz de intrare și suprafața substratului.
Calitatea cuptorului epitaxial de carbură de siliciu are în principal trei indicatori. Prima este performanța de creștere epitaxială, inclusiv uniformitatea grosimii, uniformitatea dopajului, rata de defecte și rata de creștere; Al doilea este performanța de temperatură a echipamentului în sine, inclusiv viteza de încălzire/răcire, temperatura maximă, uniformitatea temperaturii; și, în sfârșit, performanța costurilor echipamentului în sine, inclusiv prețul unitar și capacitatea de producție.
CVD orizontal de perete fierbinte, CVD planetar cu perete cald și CVD-ul vertical cu perete cvasi-fierbinte sunt soluțiile tehnologice de echipamente epitaxiale care au fost aplicate comercial în această etapă. Cele trei echipamente tehnice au, de asemenea, propriile caracteristici și pot fi selectate în funcție de nevoi. Diagrama structurii este prezentată în figura de mai jos:

Sistemul CVD orizontal de perete fierbinte este, în general, un sistem de creștere cu dimensiuni mari cu un singur aparat, condus de flotarea și rotirea aerului. Este ușor să se obțină indicatori buni în wafer. Modelul reprezentativ este PE1O6 al companiei LPE din Italia. Această mașină poate realiza încărcarea și descărcarea automată a napolitanelor la 900 ℃. Principalele caracteristici sunt o rată de creștere ridicată, un ciclu epitaxial scurt, o consistență bună în cadrul plafonului și între cuptoare, etc. Are cea mai mare cotă de piață din China.

Conform rapoartelor oficiale LPE, combinate cu utilizarea utilizatorilor majori, produsele de wafer epitaxiale de 100-150 mm (4-6 inci) 4H-SIC cu o grosime mai mică de 30μM produsă de cuptorul epitaxial PE1O6 poate atinge în mod stabil următorii indicatori: Intra-Wafer Gheslaxial Non-Eniformitate ≤2%, suprafață, suprafață, concentrație de dimensiuni duble, concentrând non-euniformitate ≤5%, suprafață, suprafață Densitatea defectelor ≤1cm-2, suprafață fără defecte de suprafață (celula unitară 2mm × 2mm) ≥90%.
Companiile interne precum JSG, CETC 48, Naura și NASO au dezvoltat echipamente epitaxiale de carbură de siliciu monolitic cu funcții similare și au obținut livrări la scară largă. De exemplu, în februarie 2023, JSG a lansat un echipament epitaxial de 6 inci cu dublu-wafer. Echipamentul folosește straturile superioare și inferioare ale straturilor superioare și inferioare ale părților de grafit ale camerei de reacție pentru a crește două napolitane epitaxiale într -un singur cuptor, iar gazele cu proces superior și inferior pot fi reglementate separat, cu o diferență de temperatură de ≤5 ° C, care constituie în mod eficient dezavantajul.SiC Acoperire Piese pe jumătate demonite.Am furnizăm piese de 6 inci și 8 inci pe jumătate de lună pentru utilizatori.

Sistemul CVD planetar cu perete cald, cu un aranjament planetar al bazei, se caracterizează prin creșterea mai multor napolitane într-un singur cuptor și o eficiență ridicată a producției. Modelele reprezentative sunt AIXG5WWC (8x150mm) și G10-SIC (9 × 150mm sau 6 × 200mm) echipamente epitaxiale ale Aixtron din Germania.
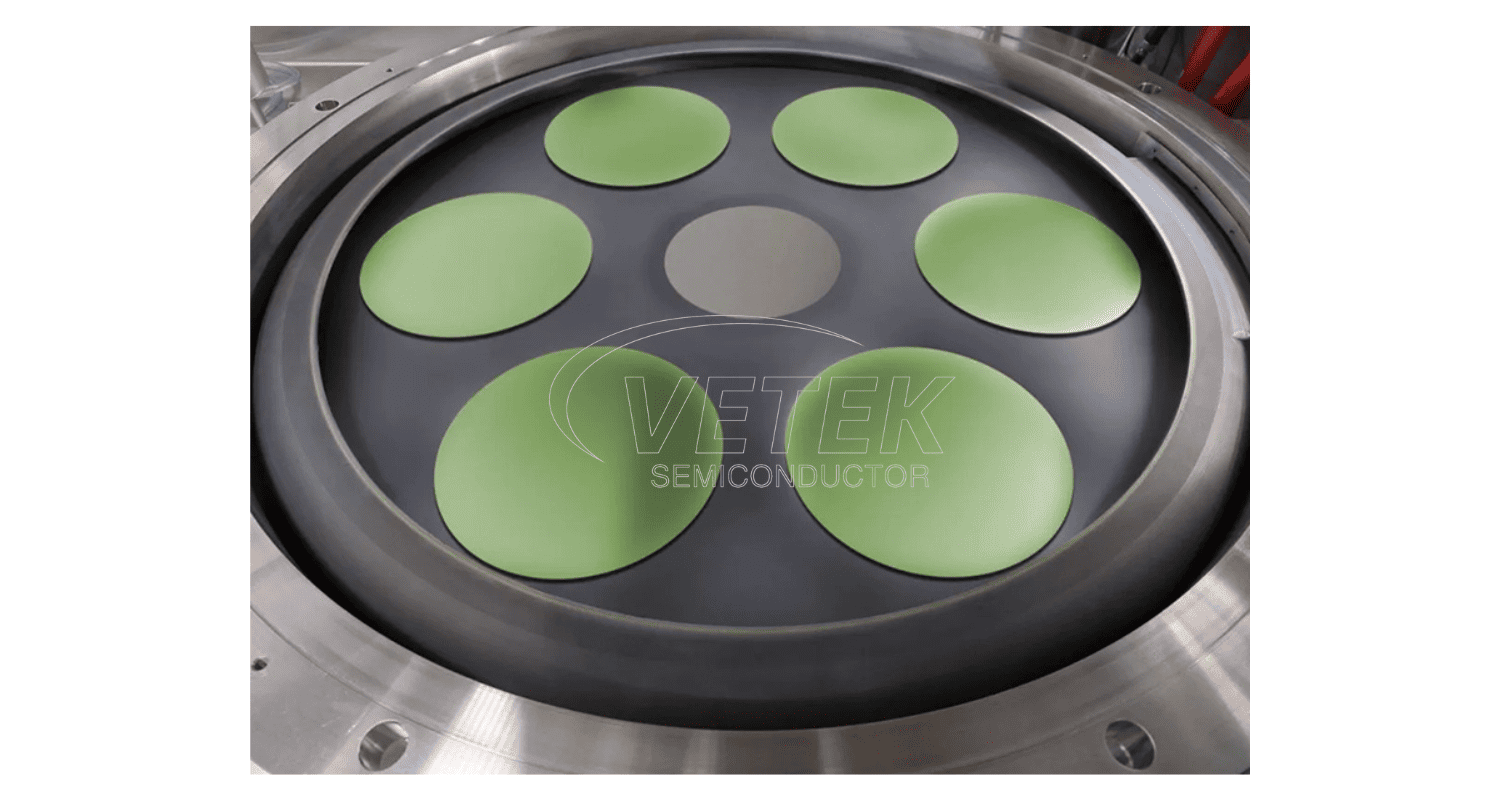
According to Aixtron's official report, the 6-inch 4H-SiC epitaxial wafer products with a thickness of 10μm produced by the G10 epitaxial furnace can stably achieve the following indicators: inter-wafer epitaxial thickness deviation of ±2.5%, intra-wafer epitaxial thickness non-uniformity of 2%, inter-wafer doping concentration deviation of ±5%, intra-wafer Non-uniformitatea concentrației de dopaj <2%.
Până în prezent, acest tip de model este rar utilizat de utilizatorii casnici, iar datele de producție a lotului sunt insuficiente, ceea ce restricționează într -o anumită măsură aplicația sa de inginerie. În plus, datorită barierelor tehnice ridicate ale cuptoarelor epitaxiale multi-wafer în ceea ce privește controlul câmpului de temperatură și al fluxului, dezvoltarea de echipamente interne similare este încă în stadiul de cercetare și dezvoltare și nu există un model alternativ. În timp, putem oferi susceptibilul planetar AIXTRON precum 6 inch și 8 inch cu acoperire TAC sau acoperire sic.
Sistemul CVD vertical cvasi-cald se rotește în principal la viteză mare prin asistență mecanică externă. Caracteristica sa este că grosimea stratului vâscos este redusă eficient printr -o presiune mai mică a camerei de reacție, crescând astfel rata de creștere epitaxială. În același timp, camera sa de reacție nu are un perete superior pe care pot fi depuse particulele SIC și nu este ușor să produceți obiecte în cădere. Are un avantaj inerent în controlul defectelor. Modelele reprezentative sunt cuptoarele epitaxiale cu un singur wafer Epirevos6 și Epirevos8 din Nuflare din Japonia.
Conform Nuflare, rata de creștere a dispozitivului Epirevos6 poate atinge mai mult de 50μm/h, iar densitatea defectelor de suprafață a plafonului epitaxial poate fi controlată sub 0,1cm-²; În ceea ce privește controlul uniformității, inginerul Nuflare Yoshiaki Daigo a raportat rezultatele uniformității intra-wafer ale unei placi epitaxiale de 6 inci de 10 μm grosime de 6 inci cultivată folosind Epirevos6, iar grosimea intra-wafer și concentrația de dopare a concentrației non-uniformității au atins 1%, respectiv 2,6%.Cilindrul de grafit superior.
În prezent, producătorii de echipamente interne, cum ar fi a treia generație și JSG, au proiectat și lansat echipamente epitaxiale cu funcții similare, dar nu au fost utilizate la scară largă.
În general, cele trei tipuri de echipamente au propriile lor caracteristici și ocupă o anumită cotă de piață în diferite nevoi de aplicații:
Structura CVD orizontală cu perete fierbinte prezintă o rată de creștere ultra-rapidă, calitate și uniformitate, funcționare și întreținere a echipamentelor simple și aplicații de producție pe scară largă. Cu toate acestea, datorită tipului cu un singur wafer și întreținerii frecvente, eficiența producției este scăzută; CVD -ul planetar cu perete cald adoptă, în general, o structură de tavă de 6 (bucată) × 100 mm (4 inci) sau 8 (bucată) × 150 mm (6 inci), ceea ce îmbunătățește foarte mult eficiența producției echipamentului în ceea ce privește capacitatea de producție, dar este dificil de controlat consistența multiplelor piese, iar randamentul de producție este încă cea mai mare problemă; CVD-ul vertical cu perete cvasi-fierbinte are o structură complexă, iar controlul defectului de calitate al producției de placă epitaxială este excelent, ceea ce necesită experiență de întreținere și utilizare a echipamentelor extrem de bogate.
Rata de creștere rapidă
simplu Structura echipamentului și
Întreținere convenabilă
Capacitate mare de producție
Eficiență ridicată a producției
Control bun al defectelor produsului
Cameră de reacție lungă
Ciclul de întreținere
Structură complexă
greu de controlat
Consistența produsului
Structura complexă a echipamentelor,
Întreținere dificilă
Reprezentant
echipament
producători
CVD orizontal de perete fierbinte
Perete cald planetar cwd
Perete cvasi-fierbinte CTD
Avantaje
Dezavantaje
Ciclu de întreținere scurtă
Italia LPE, Japonia Tel
Germania Aixtron
Japonia Nuflare
Odată cu dezvoltarea continuă a industriei, aceste trei tipuri de echipamente vor fi optimizate și modernizate iterativ în ceea ce privește structura, iar configurația echipamentului va deveni din ce în ce mai perfectă, jucând un rol important în potrivirea specificațiilor napolitanelor epitaxiale cu grosimi diferite și cerințe de defecte.



+86-579-87223657


Drumul Wangda, strada Ziyang, județul Wuyi, orașul Jinhua, provincia Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Toate drepturile rezervate.
Links | Sitemap | RSS | XML | Politica de confidențialitate |
